장비현황
SNS 공유
건식식각기(폴리외) P5000
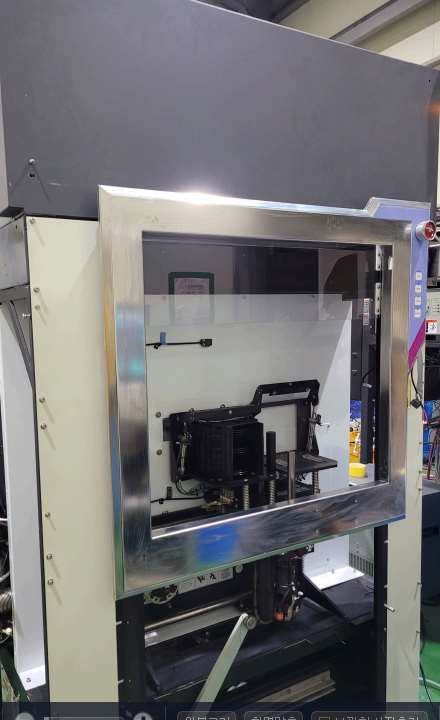
- 제작사명 모델명
- Applied Materials P5000
- 표준분류
- 기계가공/시험장비 > 반도체장비 > 식각장비
설치장소 : 장안단지 전력반도체센터 3층
장비문의 : 051-513-3910
-
장비설명
-
1. 용도 : 건식식각기는 주 반옹성 챔버별로 Poly-Si, Si02, SiN 3가지 사양을 모두 만족S 수 있는 장비. 2. 기? Status) 1) 실리콘 기판 (Si Wafer) - 기판크기 (Wafer Size): 150mm±0.2mm - 기판두께 (Wafer Thickness pm - 기판플랫존 (Wafer Flat Zone): 47-5mm ±0.25m mjun(J El DA Type) 2) 실리콘 카바이드 기판 (SiC Wafei (Wafer Size): 150mm±0.2mm - 기판두께(Wafer Thickness): 350±25|im - 기판플랫존(Wafer Flat Zorn ±0.25mm|w(JEIDA Type) 3. 플라즈마 발생기 1) MERIE g라즈마 Source 2) 파워 범위(Power Range): 1( Owatt 3) RF Power 발생기《RF Generator): 13.56MHz, MAX l,250watt출력 4. 진공챔버(Vacuum Chamt 각챔버 압력: <lmT - 허용 리크 비옳(Leak Rate): <2mT/min 2) 로드락 챔버 압력 : <10mT - 허용 리크 비-
e): S10mT/min 5. 온도 조절 1) 전극 온도: 0°C~50eC (별도의 칠러로 제어) 幻 챔버 측벽 온도: 30°C~80°C Heat & Exchanger 3) 온도 컨트를 범위: ±(k5°C
-
1. 용도 : 건식식각기는 주 반옹성 챔버별로 Poly-Si, Si02, SiN 3가지 사양을 모두 만족S 수 있는 장비. 2. 기? Status) 1) 실리콘 기판 (Si Wafer) - 기판크기 (Wafer Size): 150mm±0.2mm - 기판두께 (Wafer Thickness pm - 기판플랫존 (Wafer Flat Zone): 47-5mm ±0.25m mjun(J El DA Type) 2) 실리콘 카바이드 기판 (SiC Wafei (Wafer Size): 150mm±0.2mm - 기판두께(Wafer Thickness): 350±25|im - 기판플랫존(Wafer Flat Zorn ±0.25mm|w(JEIDA Type) 3. 플라즈마 발생기 1) MERIE g라즈마 Source 2) 파워 범위(Power Range): 1( Owatt 3) RF Power 발생기《RF Generator): 13.56MHz, MAX l,250watt출력 4. 진공챔버(Vacuum Chamt 각챔버 압력: <lmT - 허용 리크 비옳(Leak Rate): <2mT/min 2) 로드락 챔버 압력 : <10mT - 허용 리크 비-
-
구성 및 성능
- 건식식각기는 주 반응성 챔버별로 Poly-Si, SiO2, SiN 3가지 Film을 식각하는 장비 임. 3개의 챔버에 식각 막질 른 반응성 가스를 이용하여 플라즈마 상태에서 웨이퍼에 설계된 미세 선폭의 Poly-Si, SiO2, SiN 막질을 식각하 화규소 (SiC》기판 전용 공정에 사용 된다.

 부산테크노파크
부산테크노파크